poly-Si電極とハフニウム酸化膜ゲート絶縁膜界面の
化学反応機構を解明
2005年7月12日
東京大学大学院工学研究科の尾嶋正治(おしま・まさはる)教授,岡林潤(おかばやし・じゅん)助手のグループと半導体理工学研究センター(STARC)は,PF, BL-2Cの高分解能光電子分光装置で,LSI用高誘電率(high-k)ゲート絶縁膜のひとつであるハフニウム酸化膜と電極界面の化学反応過程を初めて明らかにしました。
LSIの高集積化によるゲート絶縁膜の薄膜化に伴い,次世代高誘電率(high-k)ゲート絶縁膜としてハフニウム酸化膜(HfO2膜)が有望視されています。しかし電極材料としてpoly-Siを用いると,成膜工程中の高温加熱処理において,poly-Si電極とHfO2膜の界面が不安定になりリーク電流が発生するという問題を抱えていました。今回の研究では,poly-Si電極/HfO2膜/シリコン基板というデバイス構造状態での薄い試料を作製し,poly-Si電極表面酸化膜を希フッ酸で除去した後、上下界面からの信号を区別するために,検出角度0°と60°で軟X線光電子スペクトルを測定しました。その結果,700℃という低い温度での加熱で上部界面 (poly-Si/HfO2)からシリサイド化(電流を通しやすいハフニウムシリサイドが生成)が始まることが分かりました。これは,シリコンとHfO2が直接接触することによりSiOガスが発生し,ハフニウムとシリコンの化学反応が起こりやすくなるためと考えられました。またこの反応は,シリケート層が介在するためにシリサイド化が起こりにくくなっていた下部界面にも広がることも見出しました。今回の知見は界面反応抑制層の提案など新しいデバイスの設計に大きく貢献することが期待されます。
この成果は,Applied Physics Letters誌2005年7月4日号に掲載されました。また,2005年7月8日付の日刊工業新聞に掲載されました。
H. Takahashi, S. Toyoda, J. Okabayashi, H. Kumigashira, M. Oshima, Y. Sugita, G. L. Liu, Z. Liu and K. Usuda : Chemical reaction at the interface between polycrystalline Si electrodes and HfO2/Si gate dielectrics by annealing in ultrahigh vacuum. Appl. Phys. Lett., 87, 012903 (2005).
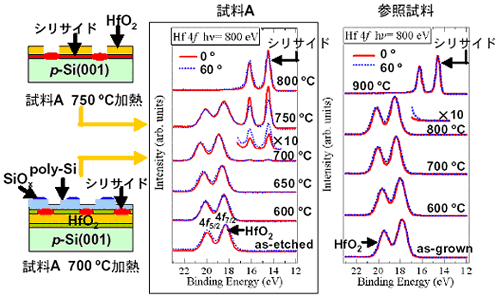
UHV加熱poly-Si/HfO2/Si試料のHf4f光電子スペクトル(参照試料:poly-Siなし)。700℃の加熱によりシリサイドの微小なピークが現れた。このピークは検出角度を60度にすると増加することから,上部界面で生成したことを意味している。
by pfw3-admin@pfiqst.kek.jp